知识星球(星球名:芯片制造与封测社区)里的学员问:用于2.5D与3D封装的TSV工艺流程是什么?有哪些需要注意的问题?
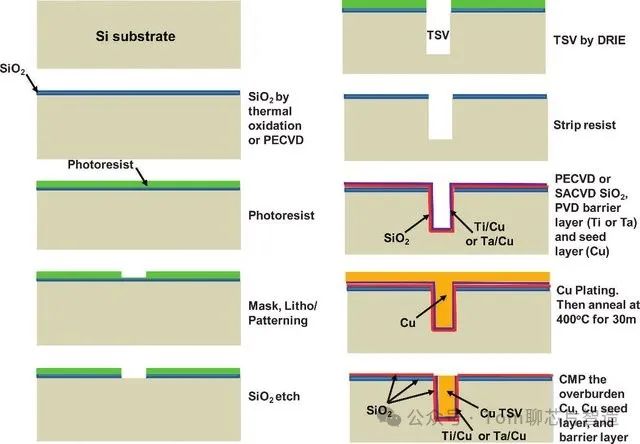
上图是TSV工艺的一般流程。TSV,全名Through-Silicon Via,又叫硅通孔工艺。
硅基底准备:流程以一块覆盖有二氧化硅(SiO₂)层的硅基底开始。这层SiO₂可以通过热氧化或等离子体增强化学气相沉积(PECVD)方法形成。
光刻:光刻胶(Photoresist)被涂布在SiO₂层上,然后通过曝光和显影步骤进行图案化,以得到后面工序要进行硅蚀刻的区域。
硅蚀刻:使用光刻图案作为掩模,采用DRIE在硅基底中蚀刻出通孔。
去除光刻胶:在蚀刻完成后,去除光刻胶以准备接下来的层沉积步骤。
沉积绝缘层和阻挡层:通过PVD,PECVD或原子层沉积(ALD)技术在孔壁上沉积一层二氧化硅来作为绝缘层,防止电子窜扰;然后沉积一层导电的阻挡层,如钛/铜(Ti/Cu)或钽/铜(Ta/Cu),以便后续的铜镀层能更好地附着,且能防止电子迁移。
铜电镀:在绝缘层和阻挡层上进行铜镀层,以填充TSV孔洞。一般通过电镀方式完成。电镀完成后,进行退火工序,释放应力。
化学机械抛光(CMP):最后,进行CMP步骤来平整表面,去除多余的铜和阻挡层,留下一个与硅基底表面平齐的铜TSV。
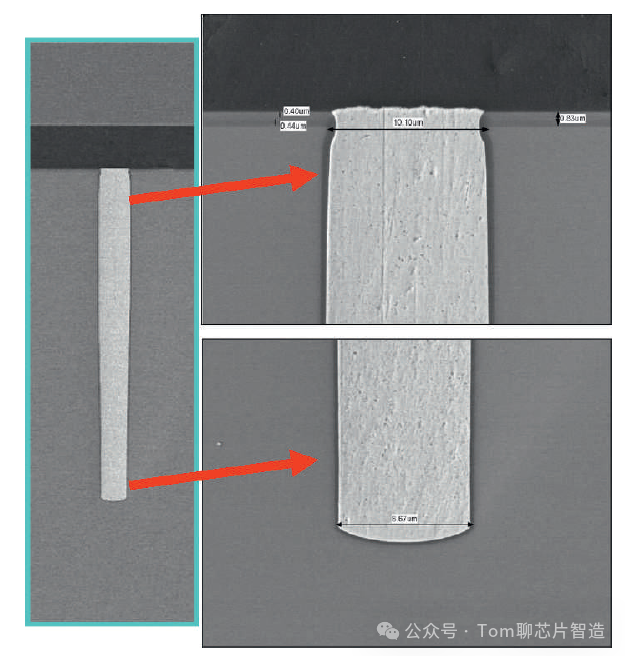
欢迎加入我的半导体制造知识社区,答疑解惑,上千个半导体行业资料共享,内容比文章丰富很多很多,适合快速提升个人能力,介绍如下:
 芯耀
芯耀




 3016
3016

 下载ECAD模型
下载ECAD模型



